igzo tft display free sample
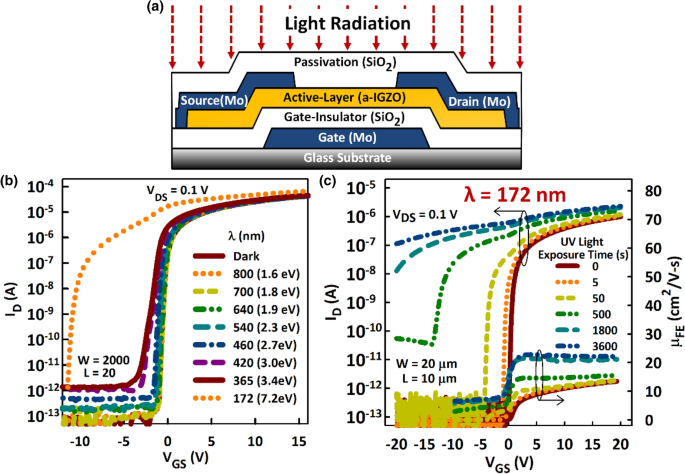
To overcome the technological and economic obstacles of amorphous indium-gallium-zinc-oxide (a-IGZO)-based display backplane for industrial production, a clean etch-stopper (CL-ES) process is developed to fabricate a-IGZO-based thin film transistor (TFT) with improved uniformity and reproducibility on 8.5th generation glass substrates (2200 mm × 2500 mm). Compared with a-IGZO-based TFT with back-channel-etched (BCE) structure, a newly formed ES nano-layer ( 100 nm) and a simultaneous etching of a-IGZO nano-layer (30 nm) and source-drain electrode layer are firstly introduced to a-IGZO-based TFT device with CL-ES structure to improve the uniformity and stability of device for large-area display. The saturation electron mobility of 8.05 cm2/V s and the V th uniformity of 0.72 V are realized on the a-IGZO-based TFT device with CL-ES structure. In the negative bias temperature illumination stress and positive bias thermal stress reliability testing under a ± 30 V bias for 3600 s, the measured V th shift of CL-ES-structured device significantly decreased to - 0.51 and + 1.94 V, which are much lower than that of BCE-structured device (- 3.88 V, + 5.58 V). The electrical performance of the a-IGZO-based TFT device with CL-ES structure implies that the economic transfer from a silicon-based TFT process to the metal oxide semiconductor-based process for LCD fabrication is highly feasible.
To overcome the technological and economic obstacles of amorphous indium-gallium-zinc-oxide (a-IGZO)-based display backplane for industrial production, a clean etch-stopper (CL-ES) process is developed to fabricate a-IGZO-based thin film transistor (TFT) with improved uniformity and reproducibility on 8.5th generation glass substrates (2200 mm × 2500 mm). Compared with a-IGZO-based TFT with back-channel-etched (BCE) structure, a newly formed ES nano-layer (~ 100 nm) and a simultaneous etching of a-IGZO nano-layer (30 nm) and source-drain electrode layer are firstly introduced to a-IGZO-based TFT device with CL-ES structure to improve the uniformity and stability of device for large-area display. The saturation electron mobility of 8.05 cm 2 /V s and the V th uniformity of 0.72 V are realized on the a-IGZO-based TFT device with CL-ES structure. In the negative bias temperature illumination stress and positive bias thermal stress reliability testing under a ± 30 V bias for 3600 s, the measured V th shift of CL-ES-structured device significantly decreased to - 0.51 and + 1.94 V, which are much lower than that of BCE-structured device (- 3.88 V, + 5.58 V). The electrical performance of the a-IGZO-based TFT device with CL-ES structure implies that the economic transfer from a silicon-based TFT process to the metal oxide semiconductor-based process for LCD fabrication is highly feasible.
IGZO-TFT (Indium Galium Zinc Oxide-Thin Film Transistor) is a promising technology for controlling large display areas and large area sensors because of its very low leakage current in the off state and relatively low cost. IGZO has been used as a switching gate for a large area flat-panel detector. The photon counting capability for X-ray medical imaging has been investigated and expected for low-dose exposure and material determination. Here the design and fabrication of a charge sensitive preamplifier and analog counter using IGZO-TFT processes and its performance are reported for the first time to be used for radiation photon counting applications.
A visible-blind ultraviolet (UV) photodetector was designed based on a three-terminal electronic device of thin-film transistor (TFT) coupled with two-terminal p-n junction optoelectronic device, in hope of combining the beauties of both of the devices together. Upon the uncovered back-channel surface of amorphous indium-gallium-zinc-oxide (IGZO) TFT, we fabricated PEDOT:PSS/SnO x /IGZO heterojunction structure, through which the formation of a p-n junction and directional carrier transfer of photogenerated carriers were experimentally validated. As expected, the photoresponse characteristics of the newly designed photodetector, with a photoresponsivity of 984 A/W at a wavelength of 320 nm, a UV-visible rejection ratio up to 3.5 × 10 7 , and a specific detectivity up to 3.3 × 10 14 Jones, are not only competitive compared to the previous reports but also better than those of the pristine IGZO phototransistor. The hybrid photodetector could be operated in the off-current region with low supply voltages (<0.1 V) and ultralow power dissipation (<10 nW under illumination and ∼0.2 pW in the dark). Moreover, by applying a short positive gate pulse onto the gate, the annoying persistent photoconductivity presented in the wide band gap oxide-based devices could be suppressed conveniently, in hope of improving the response rate. With the terrific photoresponsivity along with the advantages of photodetecting pixel integration, the proposed phototransistor could be potentially used in high-performance visible-blind UV photodetector pixel arrays.
An immunosensor is proposed based on the indium-gallium-zinc-oxide (IGZO) electric-double-layer thin-film transistor (EDL TFT) with a separating extended gate. The IGZO EDL TFT has a field-effect mobility of 24.5 cm2 V-1 s-1 and an operation voltage less than 1.5 V. The sensors exhibit the linear current response to label-free target immune molecule in the concentrations ranging from 1.6 to 368 × 10-15 g/ml with a detection limit of 1.6 × 10-15 g/ml (0.01 fM) under an ultralow operation voltage of 0.5 V. The IGZO TFT component demonstrates a consecutive assay stability and recyclability due to the unique structure with the separating extended gate. With the excellent electrical properties and the potential for plug-in-card-type multifunctional sensing, extended-gate-type IGZO EDL TFTs can be promising candidates for the development of a label-free biosensor for public health applications.
In this study, InGaZnO (IGZO) thin film transistors (TFTs) with a dual active layer (DAL) structure are fabricated by inserting a homogeneous embedded conductive layer (HECL) in an amorphous IGZO (a-IGZO) channel with the aim of enhancing the electrical characteristics of conventional bottom-gate-structure TFTs. A highly conductive HECL (carrier concentration at 1.6 × 1013 cm-2, resistivity at 4.6 × 10-3 Ω∙cm, and Hall mobility at 14.6 cm2/Vs at room temperature) is fabricated using photochemical H-doping by irradiating UV light on an a-IGZO film. The electrical properties of the fabricated DAL TFTs are evaluated by varying the HECL length. The results reveal that carrier mobility increased proportionally with the HECL length. Further, a DAL TFT with a 60-μm-long HECL embedded in an 80-μm-long channel exhibits comprehensive and outstanding improvements in its electrical properties: a saturation mobility of 60.2 cm2/Vs, threshold voltage of 2.7 V, and subthreshold slope of 0.25 V/decade against the initial values of 19.9 cm2/Vs, 4.7 V, and 0.45 V/decade, respectively, for a TFT without HECL. This result confirms that the photochemically H-doped HECL significantly improves the electrical properties of DAL IGZO TFTs. PMID:25435832
In this study, InGaZnO (IGZO) thin film transistors (TFTs) with a dual active layer (DAL) structure are fabricated by inserting a homogeneous embedded conductive layer (HECL) in an amorphous IGZO (a-IGZO) channel with the aim of enhancing the electrical characteristics of conventional bottom-gate-structure TFTs. A highly conductive HECL (carrier concentration at 1.6 × 10(13) cm(-2), resistivity at 4.6 × 10(-3) Ω∙cm, and Hall mobility at 14.6 cm(2)/Vs at room temperature) is fabricated using photochemical H-doping by irradiating UV light on an a-IGZO film. The electrical properties of the fabricated DAL TFTs are evaluated by varying the HECL length. The results reveal that carrier mobility increased proportionally with the HECL length. Further, a DAL TFT with a 60-μm-long HECL embedded in an 80-μm-long channel exhibits comprehensive and outstanding improvements in its electrical properties: a saturation mobility of 60.2 cm(2)/Vs, threshold voltage of 2.7 V, and subthreshold slope of 0.25 V/decade against the initial values of 19.9 cm(2)/Vs, 4.7 V, and 0.45 V/decade, respectively, for a TFT without HECL. This result confirms that the photochemically H-doped HECL significantly improves the electrical properties of DAL IGZO TFTs.
The deposition of the top gate dielectric in thin film transistor (TFT)-based dual-gate ion-sensitive field-effect transistors (DG ISFETs) is critical, and expected not to affect the bottom gate TFT characteristics, while providing a higher pH sensitive surface and efficient capacitive coupling between the gates. Amorphous Ta2O5, in addition to having good sensing properties, possesses a high dielectric constant of ˜25 making it well suited as the top gate dielectric in a DG ISFET by providing higher capacitive coupling (ratio of C top/C bottom) leading to higher amplification. To avoid damage of the a-IGZO channel reported to be caused by plasma exposure, deposition of Ta2O5 by e-beam evaporation followed by annealing was investigated in this work to obtain sensitivity over the Nernst limit. The deteriorated bottom gate TFT characteristics, indicated by an increase in the channel conductance, confirmed that plasma exposure is not the sole contributor to the changes. Oxygen vacancies at the Ta2O5/a-IGZO interface, which emerged during processing, increased the channel conductivity, became filled by optimum annealing in oxygen at 400 °C for 1 h, which was confirmed by an x-ray photoelectron spectroscopy depth profiling analysis. The obtained pH sensitivity of the TFT-based DG ISFET was 402 mV pH-1, which is about 6.8 times the Nernst limit (59 mV pH-1). The concept of capacitive coupling was also demonstrated by simulating an a-IGZO-based DG TFT structure. Here, the exposure of the top gate dielectric to the electrolyte without applying any top gate bias led to changes in the measured threshold voltage of the bottom gate TFT, and this obviated the requirement of a reference electrode needed in conventional ISFETs and other reported DG ISFETs. These devices, with high sensitivities and requiring low volumes (˜2 μl) of analyte solution, could be potential candidates for utilization as chemical sensors and biosensors.
In this study, we investigated how the structure and oxygen flow rate (OFR) during the sputter-deposition affects the photo-responses of amorphous indium-gallium-zinc-oxide (a-IGZO)-based photodetector devices. As the result of comparing three types of device structures with one another, which are a global Schottky diode, local Schottky diode, and thin-film transistor (TFT), the IGZO TFT with the gate pulse technique suppressing the persistent photoconductivity (PPC) is the most promising photodetector in terms of a high photo-sensitivity and uniform sensing characteristic. In order to analyze the IGZO TFT-based photodetectors more quantitatively, the time-evolution of sub-gap density-of-states (DOS) was directly observed under photo-illumination and consecutively during the PPC-compensating period with applying the gate pulse. It shows that the increased ionized oxygen vacancy (VO2+) defects under photo-illumination was fully recovered by the positive gate pulse and even overcompensated by additional electron trapping. Based on experimentally extracted sub-gap DOS, the origin on PPC was successfully decomposed into the hole trapping and the VO ionization. Although the VO ionization is enhanced in lower OFR (O-poor) device, the PPC becomes more severe in high OFR (O-rich) device because the hole trapping dominates the PPC in IGZO TFT under photo-illumination rather than the VO ionization and more abundant holes are trapped into gate insulator and/or interface in O-rich TFTs. Similarly, the electron trapping during the PPC-compensating period with applying the positive gate pulse becomes more prominent in O-rich TFTs. It is attributed to more hole/electron traps in the gate insulator and/or interface, which is associated with oxygen interstitials, or originates from the ion bombardment-related lower quality gate oxide in O-rich devices.
We report two-step annealing, high temperature and sequent low temperature, for amorphous indium-gallium-zinc-oxide (a-IGZO) thin-film transistor (TFT) to improve its stability and device performance. The annealing is carried out at 300 oC in N2 ambient for 1 h (1st step annealing) and then at 250 oC in vacuum for 10 h (2nd step annealing). It is found that the threshold voltage (VTH) changes from 0.4 V to -2.0 V by the 1st step annealing and to +0.6 V by 2nd step annealing. The mobility changes from 18 cm2V-1s-1 to 25 cm2V-1s-1 by 1st step and decreases to 20 cm2V-1s-1 by 2nd step annealing. The VTH shift by positive bias temperature stress (PBTS) is 3.7 V for the as-prepared TFT, and 1.7 V for the 1st step annealed TFT, and 1.3 V for the 2nd step annealed TFT. The XPS (X-ray photoelectron spectroscopy) depth analysis indicates that the reduction in O-H bonds at the top interface (SiO2/a-IGZO) by 2nd step annealing appears, which is related to the positive VTH shift and smaller VTH shift by PBTS.
We report a tunneling contact indium-gallium-zinc oxide (IGZO) thin film transistor (TFT) with a graphene interlayer technique in this paper. A Schottky junction is realized between a metal and IGZO with a graphene interlayer, leading to a quantum tunneling of the TFT transport in saturation regions. This tunneling contact enables a significant reduction in the saturation drain voltage Vdsat compared to that of the thermionic emission TFTs, which is usually equal to the gate voltage minus their threshold voltages. Measured temperature independences of the subthreshold swing confirm a transition from the thermionic emission to quantum tunneling transports depending on the gate bias voltages in the proposed device. The tunneling contact TFTs with the graphene interlayer have implications to reduce the power consumptions of certain applications such as the active matrix OLED display.
Device characteristics changes in an a-IGZO thin film transistor under light illumination and at raised temperature have been investigated. Light exposure causes a large leakage current, which is more obvious with an increase in the illumination energy, power and the temperature. The increase in the leakage current is due to the trap assisted photon excitation process that generates electron-hole pairs and the mechanism is enhanced with the additional thermal energy. The leakage current comes from the source side because holes generated in the process drift to the source side and therefore lower the barrier height. The above mechanism has been further verified with experiments of drain bias induced shifts in the threshold voltage and the subthreshold slope.
An amorphous indium-gallium-zinc-oxide (a-IGZO) thin film transistor (TFT) was fabricated by a self-aligned imprint lithography (SAIL) method with a sacrificial photoresist layer. The SAIL is a top-down method to fabricate a TFT using a three-dimensional multilayer etch mask having all pattern information for the TFT. The sacrificial layer was applied in the SAIL process for the purpose of removing the resin residues that were inevitably left when the etch mask was thinned by plasma etching. This work demonstrated that the a-IGZO TFT could be fabricated by the SAIL process with the sacrificial layer. Specifically, the simple fabrication process utilized in this study can be utilized for the TFT with a plasma-sensitive semiconductor such as the a-IGZO and further extended for the roll-to-roll TFT fabrication.
We present a gas sensitive thin-film transistor (TFT) based on an amorphous Indium-Gallium-Zinc-Oxide (a-IGZO) semiconductor as the sensing layer, which is fabricated on a free-standing flexible polyimide foil. The photo-induced sensor response to NO₂ gas at room temperature and the cross-sensitivity to humidity are investigated. We combine the advantages of a transistor based sensor with flexible electronics technology to demonstrate the first flexible a-IGZO based gas sensitive TFT. Since flexible plastic substrates prohibit the use of high operating temperatures, the charge generation is promoted with the help of UV-light absorption, which ultimately triggers the reversible chemical reaction with the trace gas. Furthermore, the device fabrication process flow can be directly implemented in standard TFT technology, allowing for the parallel integration of the sensor and analog or logical circuits.
We present a gas sensitive thin-film transistor (TFT) based on an amorphous Indium–Gallium–Zinc–Oxide (a-IGZO) semiconductor as the sensing layer, which is fabricated on a free-standing flexible polyimide foil. The photo-induced sensor response to NO2 gas at room temperature and the cross-sensitivity to humidity are investigated. We combine the advantages of a transistor based sensor with flexible electronics technology to demonstrate the first flexible a-IGZO based gas sensitive TFT. Since flexible plastic substrates prohibit the use of high operating temperatures, the charge generation is promoted with the help of UV-light absorption, which ultimately triggers the reversible chemical reaction with the trace gas. Furthermore, the device fabrication process flow can be directly implemented in standard TFT technology, allowing for the parallel integration of the sensor and analog or logical circuits. PMID:29373524
We report a high-performance amorphous Indium-Gallium-Zinc-Oxide (a-IGZO) thin-film transistor (TFT) with new copper-chromium (Cu-Cr) alloy source/drain electrodes. The TFT shows a high mobility of 39.4 cm 2 ·V - 1 ·s - 1 a turn-on voltage of -0.8 V and a low subthreshold swing of 0.47 V/decade. Cu diffusion is suppressed because pre-annealing can protect a-IGZO from damage during the electrode sputtering and reduce the copper diffusion paths by making film denser. Due to the interaction of Cr with a-IGZO, the carrier concentration of a-IGZO, which is responsible for high mobility, rises.
In this work, a high-performance inverter based on amorphous indium-gallium-zinc oxide thin-film transistors (TFTs) has been fabricated, which consists of a driver TFT and a load TFT. The threshold voltage (Vth) of the load TFT can be tuned by applying an area-selective laser annealing. The transfer curve of the load TFT shows a parallel shift into the negative bias direction upon laser annealing. Based on x-ray photoelectron spectroscopy analyses, the negative Vth shift can be attributed to the increase of oxygen vacancy concentration within the device channel upon laser irradiation. Compared to the untreated inverter, the laser annealed inverter shows much improved switching characteristics, including a large output swing range which is close to full swing, as well as an enhanced output voltage gain. Furthermore, the dynamic performance of ring oscillator based on the laser-annealed inverter is improved.
We report a high-performance amorphous Indium-Gallium-Zinc-Oxide (a-IGZO) thin-film transistor (TFT) with new copper-chromium (Cu-Cr) alloy source/drain electrodes. The TFT shows a high mobility of 39.4 cm2·V−1·s−1 a turn-on voltage of −0.8 V and a low subthreshold swing of 0.47 V/decade. Cu diffusion is suppressed because pre-annealing can protect a-IGZO from damage during the electrode sputtering and reduce the copper diffusion paths by making film denser. Due to the interaction of Cr with a-IGZO, the carrier concentration of a-IGZO, which is responsible for high mobility, rises. PMID:28773743
In this study, flexible double-gate thin-film transistor (TFT)-based amorphous indium-galliumzinc- oxide (a-IGZO) was fabricated on a polyimide substrate. Double-gate operation with connected front and back gates was compared with a single-gate operation. As a result, the double-gate a- IGZO TFT exhibited enhanced electrical characteristics as well as improved long-term reliability. Under positive- and negative-bias temperature stress, the threshold voltage shift of the double-gate operation was much smaller than that of the single-gate operation.
Decreasing the active layer thickness has been recently reported as an alternative way to achieve fully depleted oxide thin-film transistors for the realization of low-voltage operations. However, the correlation between the active layer thickness and device resistivity to environmental changes is still unclear, which is important for the optimized design of oxide thin-film transistors. In this work, the ambient gas stability of IGZO thin-film transistors is found to be strongly correlated to the IGZO thickness. The TFT with the thinnest IGZO layer shows the highest intrinsic electron mobility in a vacuum, which is greatly reduced after exposure to O2/air. The device with a thick IGZO layer shows similar electron mobility in O2/air, whereas the mobility variation measured in the vacuum is absent. The thickness dependent ambient gas stability is attributed to a high-mobility region in the IGZO surface vicinity with less sputtering-induced damage, which will become electron depleted in O2/air due to the electron transfer to adsorbed gas molecules. The O2 adsorption and deduced IGZO surface band bending is demonstrated by the ambient-pressure x-ray photoemission spectroscopy results.
In this study, we fabricate the amorphous indium gallium zinc oxide (a-IGZO) thin-film transistors (TFTs) on a stretchable substrate with a buffer stage and investigate the mechanical stability and electrical characteristics when the length of the substrate is stretched by 1.7 times. The buffer stage is responsible for the stiffness modulation of the stretchable substrate. The mobility, the threshold voltage and the on/off ratio of the stretchable a-IGZO TFT are measured to be 18.1 cm2/V·s, 1 V, and 3 × 107, respectively. Our simulation conducted by a three dimensional finite elements method reveals that the stiffness modulation reduces the stress experienced by the substrate in the stretched state by about one-tenth. In addition, the mechanical stability and electrical characteristics of the a-IGZO TFT are maintained even when the substrate is stretched by 1.7 times.
Pulse thermal processing (PTP) has been explored for low thermal budget integration of indium gallium zinc oxide (IGZO) thin film transistors (TFTs). The IGZO TFTs are exposed to a broadband (0.2-1.4 m) arc lamp radiation spectrum with 100 pulses of 1 msec pulse width. The impact of radiant exposure power on the TFT performance was analyzed in terms of the switching characteristics and bias stress reliability characteristics, respectively. The PTP treated IGZO TFTs with power density of 3.95 kW/cm 2 and 0.1 sec total irradiation time showed comparable switching properties, at significantly lower thermal budget, to furnace annealed IGZO TFT.more » The typical field effect mobility FE, threshold voltage VT, and sub-threshold gate swing S.S were calculated to be 7.8 cm 2/ V s, 8.1 V, and 0.22 V/ decade, respectively. The observed performance shows promise for low thermal budget TFT integration on flexible substrates exploiting the large-area, scalable PTP technology.« less
Pulse thermal processing (PTP) has been explored for low thermal budget integration of indium gallium zinc oxide (IGZO) thin film transistors (TFTs). The IGZO TFTs are exposed to a broadband (0.2-1.4 m) arc lamp radiation spectrum with 100 pulses of 1 msec pulse width. The impact of radiant exposure power on the TFT performance was analyzed in terms of the switching characteristics and bias stress reliability characteristics, respectively. The PTP treated IGZO TFTs with power density of 3.95 kW/cm 2 and 0.1 sec total irradiation time showed comparable switching properties, at significantly lower thermal budget, to furnace annealed IGZO TFT.more » The typical field effect mobility FE, threshold voltage VT, and sub-threshold gate swing S.S were calculated to be 7.8 cm 2/ V s, 8.1 V, and 0.22 V/ decade, respectively. The observed performance shows promise for low thermal budget TFT integration on flexible substrates exploiting the large-area, scalable PTP technology.« less
We report solution-processed, amorphous indium-gallium-zinc-oxide-based (a-IGZO-based) thin-film transistors (TFTs). Our proposed solution-processed a-IGZO films, using a simple spin-coating method, were formed through nitrate ligand-based metal complexes, and they were annealed at low temperature (250 °C) to achieve high-quality oxide films and devices. We investigated solution-processed a-IGZO TFTs with various thicknesses, ranging from 4 to 16 nm. The 4 nm-thick TFT films had smooth morphology and high-density, and they exhibited excellent performance, i.e. a high saturation mobility of 7.73 ± 0.44 cm2 V-1 s-1, a sub-threshold swing of 0.27 V dec-1, an on/off ratio of ~108, and a low threshold voltage of 3.10 ± 0.30 V. However, the performance of the TFTs degraded as the film thickness was increased. We further performed positive and negative bias stress tests to examine their electrical stability, and it was noted that the operating behavior of the devices was highly stable. Despite a small number of free charges, the high performance of the ultrathin a-IGZO TFTs was attributed to the small effect of the thickness of the channel, low bulk resistance, the quality of the a-IGZO/SiO2 interface, and high film density.
The recent rise in the market for consumer electronics has fueled extensive research in the field of display. Thin-Film Transistors (TFTs) are used as active matrix switching devices for flat panel displays such as LCD and OLED. The following investigation involves an amorphous metal-oxide semiconductor that has the potential for improved performance over current technology, while maintaining high manufacturability. Indium-Gallium-Zinc-Oxide (IGZO) is a semiconductor material which is at the onset of commercialization. The low-temperature large-area deposition compatibility of IGZO makes it an attractive technology from a manufacturing standpoint, with an electron mobility that is 10 times higher than current amorphous silicon technology. The stability of IGZO TFTs continues to be a challenge due to the presence of defect states and problems associated with interface passivation. The goal of this dissertation is to further the understanding of the role of defect states in IGZO, and investigate materials and processes needed to regulate defects to the level at which the associated influence on device operation is controlled. The relationships between processes associated with IGZO TFT operation including IGZO sputter deposition, annealing conditions and back-channel passivation are established through process experimentation, materials analysis, electrical characterization, and modeling of electronic properties and transistor behavior. Each of these components has been essential in formulating and testing several hypotheses on the mechanisms involved, and directing efforts towards achieving the goal. Key accomplishments and quantified results are summarized as follows: • XPS analysis identified differences in oxygen vacancies in samples before and after oxidizing ambient annealing at 400 °C, showing a drop in relative integrated area of the O-1s peak from 32% to 19%, which experimentally translates to over a thousand fold decrease in the channel free electron
We demonstrate a biosensor structure consisting of an IGZO (Indium-Gallium-Zinc-Oxide) TFT (thin film transistor) and an extended sensing pad. The TFT acts as the sensing and readout device, while the sensing pad ensures the isolation of biological solution from the transistor channel layer, and meanwhile increases the sensing area. The biosensor is functionalized by first applying ZnO nanorods to increase the surface area for attracting electrical charges of EGFR (epidermal growth factor receptor) antibodies. The device is able to selectively detect 36.2 fM of EGFR in the total protein solution of 0.1 ng/ml extracted from squamous cell carcinoma (SCC). Furthermore, the conjugation duration of the functionalized device with EGFR can be limited to 3 min, implying that the biosensor has the advantage for real-time detection. © 2013 Elsevier B.V. All rights reserved.
In this letter, we investigated the structural and electrical characteristics of high-κ Er2O3 and Er2TiO5 gate dielectrics on the amorphous indium-gallium-zinc-oxide (a-IGZO) thin-film transistor (TFT) devices. Compared with the Er2O3 dielectric, the a-IGZO TFT device incorporating an Er2TiO5 gate dielectric exhibited a low threshold voltage of 0.39 V, a high field-effect mobility of 8.8 cm2/Vs, a small subthreshold swing of 143 mV/decade, and a high Ion/Ioff current ratio of 4.23 × 107, presumably because of the reduction in the oxygen vacancies and the formation of the smooth surface roughness as a result of the incorporation of Ti into the Er2TiO5 film. Furthermore, the reliability of voltage stress can be improved using an Er2TiO5 gate dielectric. PMID:23294730
In this letter, we investigated the structural and electrical characteristics of high-κ Er2O3 and Er2TiO5 gate dielectrics on the amorphous indium-gallium-zinc-oxide (a-IGZO) thin-film transistor (TFT) devices. Compared with the Er2O3 dielectric, the a-IGZO TFT device incorporating an Er2TiO5 gate dielectric exhibited a low threshold voltage of 0.39 V, a high field-effect mobility of 8.8 cm2/Vs, a small subthreshold swing of 143 mV/decade, and a high Ion/Ioff current ratio of 4.23 × 107, presumably because of the reduction in the oxygen vacancies and the formation of the smooth surface roughness as a result of the incorporation of Ti into the Er2TiO5 film. Furthermore, the reliability of voltage stress can be improved using an Er2TiO5 gate dielectric.
Here, ionic liquid gated field effect transistors have been extensively studied due to their low operation voltage, ease of processing and the realization of high electric fields at low bias voltages. Here, we report ionic liquid (IL) gated thin film transistors (TFTs) based on amorphous Indium Gallium Zinc Oxide (a-IGZO) active layers and directly compare the characteristics with a standard SiO 2 gated device. The transport measurements of the top IL gated device revealed the n-channel property of the IGZO thin film with a current ON/OFF ratio ~10 5, a promising field effect mobility of 14.20 cm 2V –1s –1,more » and a threshold voltage of 0.5 V. Comparable measurements on the bottom SiO2 gate insulator revealed a current ON/OFF ratio >108, a field effect mobility of 13.89 cm 2V –1s –1 and a threshold voltage of 2.5 V. Furthermore, temperature-dependent measurements revealed that the ionic liquid electric double layer can be “frozen-in” by cooling below the glass transition temperature with an applied electrical bias. Positive and negative freezing bias locks-in the IGZO TFT “ON” and “OFF” state, respectively, which could lead to new switching and possibly non-volatile memory applications.« less
Here, ionic liquid gated field effect transistors have been extensively studied due to their low operation voltage, ease of processing and the realization of high electric fields at low bias voltages. Here, we report ionic liquid (IL) gated thin film transistors (TFTs) based on amorphous Indium Gallium Zinc Oxide (a-IGZO) active layers and directly compare the characteristics with a standard SiO 2 gated device. The transport measurements of the top IL gated device revealed the n-channel property of the IGZO thin film with a current ON/OFF ratio ~10 5, a promising field effect mobility of 14.20 cm 2V –1s –1,more » and a threshold voltage of 0.5 V. Comparable measurements on the bottom SiO2 gate insulator revealed a current ON/OFF ratio >108, a field effect mobility of 13.89 cm 2V –1s –1 and a threshold voltage of 2.5 V. Furthermore, temperature-dependent measurements revealed that the ionic liquid electric double layer can be “frozen-in” by cooling below the glass transition temperature with an applied electrical bias. Positive and negative freezing bias locks-in the IGZO TFT “ON” and “OFF” state, respectively, which could lead to new switching and possibly non-volatile memory applications.« less
Top-gate structured thin film transistors (TFTs) using In-Ga-Zn-O (IGZO) and In-Ga-O (IGO) channel compositions were investigated to reveal a feasible origin for degradation phenomenon under drain bias stress (DBS). DBS-driven instability in terms of VTH shift, deviation of the SS value, and increase in the on-state current were detected only for the IGZO-TFT, in contrast to the IGO-TFT, which did not demonstrate VTH shift. These behaviors were visually confirmed via nanoscale transmission electron microscopy and energy-dispersive x-ray spectroscopy observations. To understand the degradation mechanism, we performed ab initio molecular dynamic simulations on the liquid phases of IGZO and IGO. The diffusivities of Ga and In atoms were enhanced in IGZO, confirming the degradation mechanism to be increased atomic diffusion. PMID:25601183
Top-gate structured thin film transistors (TFTs) using In-Ga-Zn-O (IGZO) and In-Ga-O (IGO) channel compositions were investigated to reveal a feasible origin for degradation phenomenon under drain bias stress (DBS). DBS-driven instability in terms of V(TH) shift, deviation of the SS value, and increase in the on-state current were detected only for the IGZO-TFT, in contrast to the IGO-TFT, which did not demonstrate V(TH) shift. These behaviors were visually confirmed via nanoscale transmission electron microscopy and energy-dispersive x-ray spectroscopy observations. To understand the degradation mechanism, we performed ab initio molecular dynamic simulations on the liquid phases of IGZO and IGO. The diffusivities of Ga and In atoms were enhanced in IGZO, confirming the degradation mechanism to be increased atomic diffusion.
This work reports an efficient route for enhancing the performance of amorphous InGaZnO (a-IGZO) thin film transistors (TFT). The mobility was greatly improved by about 38% by means of O2 plasma treatment. Temperature-stress was carried out to investigate the stability and extract the parameters related to activation energy ( E a) and density-of-states (DOS). The DOS was calculated on the basis of the experimentally obtained E a, which can explain the experimental observation. A lower activation energy ( E a, 0.72 eV) and a smaller DOS were obtained in the O2 plasma treatment TFT based on the temperature-dependent transfer curves. The results showed that temperature stability and electrical properties enhancements in a-IGZO thin film transistors were attributed to the smaller DOS. [Figure not available: see fulltext.
This work presents the electrical characteristics of the nitrogenated amorphous InGaZnO thin film transistor (a-IGZO:N TFT). The a-IGZO:N film acting as a channel layer of a thin film transistor (TFT) device was prepared by dc reactive sputter with a nitrogen and argon gas mixture at room temperature. Experimental results show that the in situ nitrogen incorporation to IGZO film can properly adjust the threshold voltage and enhance the ambient stability of a TFT device. Furthermore, the a-IGZO:N TFT has a 44% increase in the carrier mobility and electrical reliability and uniformity also progress obviously while comparing with those not implementingmore » a nitrogen doping process.« less
Oxide semiconductors are regarded as promising materials for large-area and/or flexible electronics. In this work, a ring oscillator based on n-type indium-gallium-zinc-oxide (IGZO) and p-type tin monoxide (SnO) is presented. The IGZO thin-film transistor (TFT) shows a linear mobility of 11.9 cm²/(V∙s) and a threshold voltage of 12.2 V. The SnO TFT exhibits a mobility of 0.51 cm²/(V∙s) and a threshold voltage of 20.1 V which is suitable for use with IGZO TFTs to form complementary circuits. At a supply voltage of 40 V, the complementary inverter shows a full output voltage swing and a gain of 24 with both TFTs having the same channel length/channel width ratio. The three-stage ring oscillator based on IGZO and SnO is able to operate at 2.63 kHz and the peak-to-peak oscillation amplitude reaches 36.1 V at a supply voltage of 40 V. The oxide-based complementary circuits, after further optimization of the operation voltage, may have wide applications in practical large-area flexible electronics.
Oxide semiconductors are regarded as promising materials for large-area and/or flexible electronics. In this work, a ring oscillator based on n-type indium-gallium-zinc-oxide (IGZO) and p-type tin monoxide (SnO) is presented. The IGZO thin-film transistor (TFT) shows a linear mobility of 11.9 cm2/(V∙s) and a threshold voltage of 12.2 V. The SnO TFT exhibits a mobility of 0.51 cm2/(V∙s) and a threshold voltage of 20.1 V which is suitable for use with IGZO TFTs to form complementary circuits. At a supply voltage of 40 V, the complementary inverter shows a full output voltage swing and a gain of 24 with both TFTs having the same channel length/channel width ratio. The three-stage ring oscillator based on IGZO and SnO is able to operate at 2.63 kHz and the peak-to-peak oscillation amplitude reaches 36.1 V at a supply voltage of 40 V. The oxide-based complementary circuits, after further optimization of the operation voltage, may have wide applications in practical large-area flexible electronics. PMID:28772679
The use of a-IGZO instead of the conventional high-k dielectrics as a pH sensitive layer could lead to the simplification of fabrication steps of field effect based devices. In this work, the pH sensitivities of a-IGZO films directly deposited over a SiO{sub 2}/Si surface were studied utilizing electrolyte-insulator-semiconductor (EIS) structures. Annealing of the films was found to affect the sensitivity of the devices and the device with the film annealed at 400 {sup o}C in N{sub 2} ambience showed the better sensitivity, which reduced with further increase in the annealing temperature to 500 {sup o}C. The increased pH sensitivity withmore » the film annealed at 400 {sup o}C in N{sub 2} gas was attributed to the enhanced lattice oxygen ions (based on the XPS data) and improved C-V characteristics, while the decrease in sensitivity at an increased annealing temperature of 500 {sup o}C was attributed to defects in the films as well as the induced traps at the IGZO/SiO{sub 2} interface based on the stretched accumulation and the peak in the inversion region of C-V curves. This study could help to develop a sensor where the material (a-IGZO here) used as the active layer in a thin film transistors (TFTs) possibly could also be used as the pH sensitive layer without affecting the TFT characteristics, and thus obviating the need of high-K dielectrics for sensitivity enhancement.« less
By controlling a thin indium tin oxide (ITO), indium zinc oxide interface layer between gate insulator and indium gallium zinc oxide (IGZO), the thin-film transistor (TFT) performance can reach higher mobility as conventional IGZO as well as superior stability. For large-area display application, Applied Materials static PVD array coater (Applied Materials GmbH & Co. KG, Alzenau, Germany) using rotary targets has been developed to enable uniform thin layer deposition in display industry. Unique magnet motion parameter optimization in Pivot sputtering coater is shown to provide very uniform thin ITO layer to reach TFT performance with high mobility, not only on small scale, but also on Gen8.5 (2500 × 2200 mm glass size) production system.
We investigate the composition of the DUV-patterned sol-gel indium gallium zinc oxide (IGZO) thin-film transistors (TFTs) and observe a significant zinc loss effect during developing when the DUV exposure is insufficient. The zinc loss, however, is beneficial for increasing the mobility. Reducing zinc to indium composition ratio from 0.5 to 0.02 can effectively increase mobility from 0.27 to 7.30 cm2 V-1 s-1 when the gallium to indium ratio is fixed as 0.25 and the post annealing process is fixed as 300 °C for 2 h. On the other hand, an IGO TFT fails to deliver a uniform film and a reproducible TFT performance, revealing the critical role of zinc in forming homogeneous IGZO TFTs.
In this work, amorphous indium-gallium-zinc oxide thin-film transistors (a-IGZO TFTs) with a HfO₂ gate insulator and CF₄ plasma treatment was demonstrated for the first time. Through the plasma treatment, both the electrical performance and reliability of the a-IGZO TFT with HfO₂ gate dielectric were improved. The carrier mobility significantly increased by 80.8%, from 30.2 cm²/V∙s (without treatment) to 54.6 cm²/V∙s (with CF₄ plasma treatment), which is due to the incorporated fluorine not only providing an extra electron to the IGZO, but also passivating the interface trap density. In addition, the reliability of the a-IGZO TFT with HfO₂ gate dielectric has also been improved by the CF₄ plasma treatment. By applying the CF₄ plasma treatment to the a-IGZO TFT, the hysteresis effect of the device has been improved and the device"s immunity against moisture from the ambient atmosphere has been enhanced. It is believed that the CF₄ plasma treatment not only significantly improves the electrical performance of a-IGZO TFT with HfO₂ gate dielectric, but also enhances the device"s reliability.
We studied channel scaling behavior of fully spin coated, low temperature solution processed thin film transistor (TFT) fabricated on p++ - Si (˜1021 cm-3) as bottom gate. The solution processed, spin coated 40 nm thick amorphous Indium Gallium Zinc Oxide (a-IGZO) and 50 nm thick amorphous zirconium di-oxide (a-ZrO2) has been used as channel and low leakage dielectric at 350°C respectively. The channel scaling effect of the TFT with different width/length ratio (W/L= 2.5, 5 and 15) for same channel length (L = 10 μm) has been demonstrated. The lowest threshold voltage (Vth) is 6.25 V for the W/L=50/10. The maximum field effect mobility (μFE) has been found to be 0.123 cm2/Vs from W/L of 50/10 with the drain to source voltage (VD) of 10V and 20V gate to source voltage (VG). We also demonstrated that there is no contact resistance effect on the mobility of the fully sol-gel spin coated TFT.
Ti contact properties and their electrical contribution to an amorphous InGaZnO (a-IGZO) semiconductor-based thin film transistor (TFT) were investigated in terms of chemical, structural, and electrical considerations. TFT device parameters were quantitatively studied by a transmission line method. By comparing various a-IGZO TFT parameters with those of different Ag and Ti source/drain electrodes, Ti S/D contact with an a-IGZO channel was found to lead to a negative shift in VT (-Δ 0.52 V). This resulted in higher saturation mobility (8.48 cm2/Vs) of a-IGZO TFTs due to effective interfacial reaction between Ti and an a-IGZO semiconducting layer. Based on transmission electron microcopy, x-ray photoelectron depth profile analyses, and numerical calculation of TFT parameters, we suggest a possible Ti contact mechanism on semiconducting a-IGZO channel layers for TFTs.
We successfully integrated the high-performance oxide thin film transistors with novel IZO/IGZO dual-active-layers. The results showed that dual-active-layer (IZO/IGZO) TFTs, compared with single active layer IGZO TFTs and IZO TFTs, exhibited the excellent performances; specifically, a high field effect mobility of 14.4 cm2/Vs, a suitable threshold voltage of 0.8 V, a high on/off ratio of more than 107, a steep sub-threshold swing of 0.13 V/dec, and a substantially small threshold voltage shift of 0.51 V after temperature stress from 293 K to 353 K. In order to understand the superior performance, the density-of-states (DOS) were investigated based on the temperature-dependent transfer curves. The superior electric properties were attributed to the smaller DOS and higher carrier concentration. The proposed IZO/IGZO-TFT in this paper can be used as driving devices in the next-generation flat panel displays.
In this work, we present the results concerning the use of amorphous indium-gallium-zinc-oxide (a-IGZO) thin-film transistor (TFT) as a driving transistor of the flexible thermal and pressure sensors which are applicable to artificial skin systems. Although the a-IGZO TFT has been attracting much attention as a driving transistor of the next-generation flat panel displays, no study has been performed about the application of this new device to the driving transistor of the flexible sensors yet. The proposed thermal sensor pixel is composed of the series-connected a-IGZO TFT and ZnO-based thermistor fabricated on a polished metal foil, and the ZnO-based thermistor is replaced by the pressure sensitive rubber in the pressure sensor pixel. In both sensor pixels, the a-IGZO TFT acts as the driving transistor and the temperature/pressure-dependent resistance of the ZnO-based thermistor/pressure-sensitive rubber mainly determines the magnitude of the output currents. The fabricated a-IGZO TFT-driven flexible thermal sensor shows around a seven times increase in the output current as the temperature increases from 20 °C to 100 °C, and the a-IGZO TFT-driven flexible pressure sensors also exhibit high sensitivity under various pressure environments.
Electroless plated metals have been used for wiring and electrodes in the manufacture of electronic devices. To obtain plated patterns, etching and photoresist are generally used. However, through catalyst patterning by printing, we can obtain metal patterns without etching and photoresists by electroless plating. Solution-processed indium-gallium-zinc oxide (IGZO) has received significant attention for showing high performance and ease of preparation in air atmosphere. In this study, we prepared an electroless plated pattern by catalyst printing as electrodes of IGZO TFT. There are few reports on the application of plated metal electrodes prepared by catalyst printing to the source and drain electrodes of IGZO TFT. The prepared IGZO TFT exhibits a typical current-voltage (I-V) curve. The plated electrodes caused many problems such as performance degradation. However, our result showed that the plated metal electrodes can drive IGZO TFT. In addition, we confirm plated metal growth into the catalyst layer by cross sectional scanning electron microscopy and energy-dispersive X-ray spectroscopy (SEM/EDS) of the plated Ni. We discuss the relevance of the measured work function (WF) of the electrode materials and the performance of IGZO TFT.
In this work, we present the design of the technology and fabrication of TFTs with amorphous IGZO semiconductor and high-k gate dielectric layer in the form of hafnium oxide (HfOx). In the course of this work, the IGZO fabrication was optimized by means of Taguchi orthogonal tables approach in order to obtain an active semiconductor with reasonable high concentration of charge carriers, low roughness and relatively high mobility. The obtained Thin-Film Transistors can be characterized by very good electrical parameters, i.e., the effective mobility (μeff ≍ 12.8 cm2V-1s-1) significantly higher than that for a-Si TFTs (μeff ≍ 1 cm2V-1s-1). However, the value of sub-threshold swing (i.e., 640 mV/dec) points that the interfacial properties of IGZO/HfOx stack is characterized by high value of interface states density (Dit) which, in turn, demands further optimization for future applications of the demonstrated TFT structures.
Low temperature processable passivation materials are necessary to fabricate highly reliable amorphous InGaZnO (a-IGZO) thin-film transistors (TFT) on organic substrates for flexible device applications. We investigated 3 types of poly-siloxane (Poly-SX) passivation layers fabricated by a solution process and cured at low temperatures (180 °C) for a-IGZO TFTs. This passivation layer greatly improves the stability of the a-IGZO device even after being subjected to positive (PBS) and negative bias stress (NBS). The field effect mobility (μ) of MePhQ504010 passivated on the TFT reached 8.34 cm2/Vs and had a small threshold voltage shift of 0.9 V after PBS, -0.8 V after NBS without the hump phenomenon. Furthermore, we analyzed the hydrogen and hydroxide states in the a-IGZO layer by secondary ion mass spectrometry and X-ray photoelectron spectroscopy to determine the cause of excellent electrical properties despite the curing performed at a low temperature. These results show the potential of the solution processed Poly-SX passivation layer for flexible devices.
Hydrogen is an impurity species having an important role in the physical properties of semiconductors. Despite numerous studies, the role of hydrogen in oxide semiconductors remains an unsolved puzzle. This situation arises from insufficient information about the chemical state of the impurity hydrogen. Here, we report direct evidence for anionic hydrogens bonding to metal cations in amorphous In-Ga-Zn-O (a-IGZO) thin films for thin-film transistors (TFT) applications and discuss how the hydrogen impurities affect the electronic structure of a-IGZO. Infrared absorption spectra of self-standing a-IGZO thin films prepared by sputtering reveal the presence of hydrogen anions as a main hydrogen species (concentration is ˜1020 cm-3) along with the hydrogens in the form of the hydroxyl groups (˜1020 cm-3). Density functional theory calculations show that bonds between these hydride ions with metal centers give rise to subgap states above the top of the valence band, implying a crucial role of anionic hydrogen in the negative bias illumination stress instability commonly observed in a-IGZO TFTs.
Lowering the driving voltage and improving the stability of nanowire field emitters are essential for them to be applied in devices. In this study the characteristics of zinc oxide (ZnO) nanowire field emitter arrays (FEAs) controlled by an amorphous indium–gallium–zinc-oxide thin film transistor (a-IGZO TFT) were studied. A low driving voltage along with stabilization of the field emission current were achieved. Modulation of field emission currents up to three orders of magnitude was achieved at a gate voltage of 0–32 V for a constant anode voltage. Additionally, a-IGZO TFT control can dramatically reduce the emission current fluctuation (i.e., from 46.11 to 1.79% at an emission current of ∼3.7 µA). Both the a-IGZO TFT and ZnO nanowire FEAs were prepared on glass substrates in our research, demonstrating the feasibility of realizing large area a-IGZO TFT-controlled ZnO nanowire FEAs.
Interest in transparent oxide thin film transistors utilizing ZnO material has been on the rise for many years. Recently, however, IGZO has begun to draw more attention due to its higher stability and superior electric field mobility when compared to ZnO. In this work, we address an improved method for patterning an a-IGZO film using the SAM process, which employs a cost-efficient micro-contact printing method instead of the conventional lithography process. After a-IGZO film deposition on the surface of a SiO2-layered Si wafer, the wafer was illuminated with UV light; sources and drains were then patterned using n-octadecyltrichlorosilane (OTS) molecules by a printing method. Due to the low surface energy of OTS, cobalt was selectively deposited on the OTS-free a-IGZO surface. The selective deposition of cobalt electrodes was successful, as confirmed by an optical microscope. The a-IZGO TFT fabricated using the SAM process exhibited good transistor performance: electric field mobility (micro(FE)), threshold voltage (V(th)), subthreshold slope (SS) and on/off ratio were 2.1 cm2/Vs, 2.4 V, 0.35 V/dec and 2.9 x 10(6), respectively.
In this work, amorphous indium-gallium-zinc oxide thin-film transistors (a-IGZO TFTs) with a HfO2 gate insulator and CF4 plasma treatment was demonstrated for the first time. Through the plasma treatment, both the electrical performance and reliability of the a-IGZO TFT with HfO2 gate dielectric were improved. The carrier mobility significantly increased by 80.8%, from 30.2 cm2/V∙s (without treatment) to 54.6 cm2/V∙s (with CF4 plasma treatment), which is due to the incorporated fluorine not only providing an extra electron to the IGZO, but also passivating the interface trap density. In addition, the reliability of the a-IGZO TFT with HfO2 gate dielectric has also been improved by the CF4 plasma treatment. By applying the CF4 plasma treatment to the a-IGZO TFT, the hysteresis effect of the device has been improved and the device’s immunity against moisture from the ambient atmosphere has been enhanced. It is believed that the CF4 plasma treatment not only significantly improves the electrical performance of a-IGZO TFT with HfO2 gate dielectric, but also enhances the device’s reliability. PMID:29772767
By dissolving gallium chloride (GaCl3), indium chloride (InCl3), zinc acetate dihydrate [Zn(OAc)2·2H2O] and monoethanolamine (MEA) into a solvent of 2-methoxyethanol, the IGZO ink was synthesized. Five types of IGZO ink were prepared with different molar ratios of In:Ga:Zn, which can be used for ink-jet printing process. The thermal behaviors of IGZO ink with different formulas were investigated and the ideal annealing temperature for film formation was found to be ∼450 °C. Based on the prepared ink, amorphous IGZO thin films were directly printed on the glass substrate with a FujiFilm Dimatix ink-jet printer, followed by a thermal annealing at 450 °C for 1 h. The surface morphology, crystal structure, optical transmittance, electron mobility and carrier concentration were characterized and investigated. The ink-jet printed amorphous IGZO thin films fabricated in this work can be used as switching medium in flexible resistive random access memory devices.
A synaptic transistor emulating the biological synaptic motion is demonstrated using the memcapacitance characteristics in a Pt/HfOx/n-indium-gallium-zinc-oxide (IGZO) memcapacitor. First, the metal-oxide-semiconductor (MOS) capacitor with Pt/HfOx/n-IGZO structure exhibits analog, polarity-dependent, and reversible memcapacitance in capacitance-voltage (C-V), capacitance-time (C-t), and voltage-pulse measurements. When a positive voltage is applied repeatedly to the Pt electrode, the accumulation capacitance increases gradually and sequentially. The depletion capacitance also increases consequently. The capacitances are restored by repeatedly applying a negative voltage, confirming the reversible memcapacitance. The analog and reversible memcapacitance emulates the potentiation and depression synaptic motions. The synaptic thin-film transistor (TFT) with this memcapacitor also shows the synaptic motion with gradually increasing drain current by repeatedly applying the positive gate and drain voltages and reversibly decreasing one by applying the negative voltages, representing synaptic weight modulation. The reversible and analog conductance change in the transistor at both the voltage sweep and pulse operations is obtained through the memcapacitance and threshold voltage shift at the same time. These results demonstrate the synaptic transistor operations with a MOS memcapacitor gate stack consisting of Pt/HfOx/n-IGZO.
A synaptic transistor emulating the biological synaptic motion is demonstrated using the memcapacitance characteristics in a Pt/HfOx/n-indium-gallium-zinc-oxide (IGZO) memcapacitor. First, the metal-oxide-semiconductor (MOS) capacitor with Pt/HfOx/n-IGZO structure exhibits analog, polarity-dependent, and reversible memcapacitance in capacitance-voltage (C-V), capacitance-time (C-t), and voltage-pulse measurements. When a positive voltage is applied repeatedly to the Pt electrode, the accumulation capacitance increases gradually and sequentially. The depletion capacitance also increases consequently. The capacitances are restored by repeatedly applying a negative voltage, confirming the reversible memcapacitance. The analog and reversible memcapacitance emulates the potentiation and depression synaptic motions. The synaptic thin-film transistor (TFT) with this memcapacitor also shows the synaptic motion with gradually increasing drain current by repeatedly applying the positive gate and drain voltages and reversibly decreasing one by applying the negative voltages, representing synaptic weight modulation. The reversible and analog conductance change in the transistor at both the voltage sweep and pulse operations is obtained through the memcapacitance and threshold voltage shift at the same time. These results demonstrate the synaptic transistor operations with a MOS memcapacitor gate stack consisting of Pt/HfOx/n-IGZO.
In this paper, we propose an amorphous indium gallium zinc oxide (a-IGZO) thin-film transistor (TFT) with off-planed source/drain electrodes. We applied different metals for the source/drain electrodes with Ni and Ti to control the work function as high and low. When we measured the configuration of Ni to drain and source to Ti, the a-IGZO TFT showed increased driving current, decreased leakage current, a high on/off current ratio, low subthreshold swing, and high mobility. In addition, we conducted a reliability test with a gate bias stress test at various temperatures. The results of the reliability test showed the Ni drain and Ti drain had an equivalent effective energy barrier height. Thus, we confirmed that the proposed off-planed structure improved the electrical characteristics of the fabricated devices without any degradation of characteristics. Through the a-IGZO TFT with different source/drain electrode metal engineering, we realized high-performance TFTs for next-generation display devices.
We report the effect of Y 2 O 3 passivation by atomic layer deposition (ALD) using various oxidants, such as H 2 O, O 2 plasma, and O 3 , on In-Ga-Zn-O thin-film transistors (IGZO TFTs). A large negative shift in the threshold voltage (V th ) was observed in the case of the TFT subjected to the H 2 O-ALD Y 2 O 3 process; this shift was caused by a donor effect of negatively charged chemisorbed H 2 O molecules. In addition, degradation of the IGZO TFT device performance after the O 2 plasma-ALD Y 2 O 3 process (field-effect mobility (μ) = 8.7 cm 2 /(V·s), subthreshold swing (SS) = 0.77 V/dec, and V th = 3.7 V) was observed, which was attributed to plasma damage on the IGZO surface adversely affecting the stability of the TFT under light illumination. In contrast, the O 3 -ALD Y 2 O 3 process led to enhanced device stability under light illumination (ΔV th = -1 V after 3 h of illumination) by passivating the subgap defect states in the IGZO surface region. In addition, TFTs with a thicker IGZO film (55 nm, which was the optimum thickness under the current investigation) showed more stable device performance than TFTs with a thinner IGZO film (30 nm) (ΔV th = -0.4 V after 3 h of light illumination) by triggering the recombination of holes diffusing from the IGZO surface to the insulator-channel interface. Therefore, we envisioned that the O 3 -ALD Y 2 O 3 passivation layer suggested in this paper can improve the photostability of TFTs under light illumination.
In this paper, we propose a high-performance separative extended gate ion-sensitive field-effect transistor (SEGISFET) that consists of a tin dioxide (SnO2) SEG sensing part and a double-gate structure amorphous indium gallium zinc oxide (a-IGZO) thin-film transistor (TFT) with tantalum pentoxide/silicon dioxide (Ta2O5/SiO2)-engineered top-gate oxide. To increase sensitivity, we maximized the capacitive coupling ratio by applying high-k dielectric at the top-gate oxide layer. As an engineered top-gate oxide, a stack of 25 nm-thick Ta2O5 and 10 nm-thick SiO2 layers was found to simultaneously satisfy a small equivalent oxide thickness (˜17.14 nm), a low leakage current, and a stable interfacial property. The threshold-voltage instability, which is a fundamental issue in a-IGZO TFTs, was improved by low-temperature post-deposition annealing (˜87 °C) using microwave irradiation. The double-gate structure a-IGZO TFTs with engineered top-gate oxide exhibited high mobility, small subthreshold swing, high drive current, and larger on/off current ratio. The a-IGZO SEGISFETs with a dual-gate sensing mode showed a pH sensitivity of 649.04 mV pH-1, which is far beyond the Nernst limit. The non-ideal behavior of ISFETs, hysteresis, and drift effect also improved. These results show that the double-gate structure a-IGZO TFTs with engineered top-gate oxide can be a good candidate for cheap and disposable SEGISFET sensors.
We investigate photo-induced instability in thin-film transistors (TFTs) consisting of amorphous indium-gallium-zinc-oxide (a-IGZO) as active semiconducting layers by comparing with hydrogenated amorphous silicon (a-Si:H). An a-IGZO TFT exhibits a large hysteresis window in the illuminated measuring condition but no hysteresis window in the dark condition. On the contrary, a large hysteresis window measured in the dark condition in a-Si:H was not observed in the illuminated condition. Even though such materials possess the structure of amorphous phase, optical responses or photo instability in TFTs looks different from each other. Photo-induced hysteresis results from initially trapped charges at the interface between semiconductor and dielectric films or in the gate dielectric which possess absorption energy to interact with deep trap-states and affect the movement of Fermi energy level. In order to support our claim, we also perform CV characteristics in photo-induced hysteresis and demonstrate thermal-activated hysteresis. We believe that this work can provide important information to understand different material systems for optical engineering which includes charge transport and band transition.
In this work, low temperature fabrication of a sputtered high-k HfO2 gate dielectric for flexible a-IGZO thin film transistors (TFTs) on polyimide substrates was investigated. The effects of Ar-pressure during the sputtering process and then especially the post-annealing treatments at low temperature (≤200 °C) for HfO2 on reducing the density of defects in the bulk and on the surface were systematically studied. X-ray reflectivity, UV-vis and X-ray photoelectron spectroscopy, and micro-wave photoconductivity decay measurements were carried out and indicated that the high quality of optimized HfO2 film and its high dielectric properties contributed to the low concentration of structural defects and shallow localized defects such as oxygen vacancies. As a result, the well-structured HfO2 gate dielectric exhibited a high density of 9.7 g/cm3, a high dielectric constant of 28.5, a wide optical bandgap of 4.75 eV, and relatively low leakage current. The corresponding flexible a-IGZO TFT on polyimide exhibited an optimal device performance with a saturation mobility of 10.3 cm2 V-1 s-1, an Ion/Ioff ratio of 4.3 × 107, a SS value of 0.28 V dec-1, and a threshold voltage (Vth) of 1.1 V, as well as favorable stability under NBS/PBS gate bias and bending stress.
We demonstrate a dual layer IGZO thin film transistor (TFT) consisting of a 310 °C deposited c-axis aligned crystal (CAAC) 20 nm thick channel layer capped by a second, 30 nm thick, 260 °C deposited amorphous IGZO layer. The TFT exhibits a saturation field-effect mobility of ˜20 cm2/V s, exceeding the mobility of 50 nm thick single layer reference TFTs fabricated with either material. The deposition temperature of the second layer influences the mobility of the underlying transport layer. When the cap layer is deposited at room temperature (RT), the mobility in the 310 °C deposited CAAC layer is initially low (6.7 cm2/V s), but rises continuously with time over 58 days to 20.5 cm2/V s, i.e., to the same value as when the second layer is deposited at 260 °C. This observation indicates that the two layers equilibrate at RT with a time constant on the order of 5 × 106 s. An analysis based on diffusive transport indicates that the room temperature diffusivity must be of the order of 1 × 10-18 cm2 s-1 with an activation enthalpy EA < 0.2 eV for the mobility limiting species. The findings are consistent with a hypothesis that the amorphous layer deposited on top of the CAAC has a higher solubility for impurities and/or structural defects than the underlying nanocrystalline transport layer, and that the equilibra




 Ms.Josey
Ms.Josey 
 Ms.Josey
Ms.Josey